미래가치를 만드는 기업 3S KOREA
To create future value company 3S KOREA
보도자료
3S, 대면적 PLP FOUP용 캐리어 트레이 특허 취득
3S, 대면적 PLP FOUP용 캐리어 트레이 특허 취득
㈜삼에스코리아(이하 3S)는 ‘패널 수납용기에 설치되는 트레이 '와 관련된 특허권을 취득했다고
19일 공시했다. 해당 특허는 300mm 이상의 대면적 패널 레밸 패키지 (Panel Level
Package) 공정에 사용되는 FOUP (Front Opening Unified Pod)에
사용되는 트레이에 관한 부분이며 해당 특허를 활용할 경우 대면적 패널의 기밀 보관성이 향상되고 트레이의 형상특징으로 인해 제조단가 절약 및 장기
보관시에도 처짐을 최소화 할 수 있는 장점이 있다.
이번에 취득한 특허는 반도체 후공정 전문기업인 네패스 라웨와 공동으로 취득한 특허이며
2020년 8월 네패스 라웨로부터 600-300mm용 FO-PLP (Fan Out-Panel Level Package)
FOUP 개발 의뢰를 받아서 공동 개발을 하는 과정에서 나온 기술이며 개발이 완료되었던 2021년
초에 총 4개의 특허 출원을 하였었는데 이번에 그중 하나가 특허 등록이 된 것이다. 현재 개발 완료된 FO-PLP FOUP은 관련 기술을 적용하여 네패스
라웨 제조공정에 투입되어 양산에 적용하고 있다.
최근 반도체 후공정 관련 기술이 중요시되는 이유는 반도체 시장에서 발생한 2가지의 주요한 변화 때문이다. 첫째,
반도체 전공정에서의 "무어의 법칙(2년마다
집적도/성능 2배 증가)"이
더 이상 성립되기 어려울 만큼 한계에 다다르고 있다는 점이다. 특히
EUV의 도입을 통해 추가적인 집적도 개선 작업이 나오고 있으나, EUV의 장비가격이 비싼
만큼 미세화를 위한 추가적인 비용이 커지고 있다. 즉, 전공정에서
무어의 법칙을 이루기 위한 한계비용이 체증하고 있다. 따라서 후공정에서의 작업들로 이를 상쇄시켜줄 필요성이
증가하고 있다. 둘째, SoC로 대변되는 시스템온칩에서 칩
사이즈가 커지며 나타나는 수율 감소 문제를 여러 개의 IP block으로 쪼개어 Chiplet 구조 형태로 가는 방식들이 나타나고 있다. 이를 통해
수율을 높이고 공정효율성을 확대시키고 있다. 이는 새로운 패키징 방식을 등장시키며, 관련된 소부장 공급망 또한 변화시키고 있다.
위 2가지 변화로 인해서 나타나는 후공정에서의
변화와 특징들을 요약하면 (1) 후공정에도
반도체의 팹 공정이 도입되기 시작했다는 점이다. 이는 주로
Advanced 패키징 공정에서 나타나는 방식이다. 이로 인해 전공정에서 사용되던 일부
웨이퍼 캐리어가 후공정에서도 사용되며 역할과 비중을 상승시키고 있다. (2) Chiplet 구조의 등장이다. Chiplet 구조의 등장은 새로운 패키징 방식을 등장시켰다. 새로운
패키징 방식은 FC 패키징 방식, CoWoS나 Foveros와 같은 실리콘 인터포저로 칩들을 묶는 방식이나, 실리콘
브릿지 (EMIB 활용)로 묶는 방식 등을 등장시키고 있다. 이러한 변화로 인해 기존에 단순히 보호와 연결만을 위한 반도체 패키징의 역할이 최근들어 성능 차별화의 주요
도구로 사용되고 있다.
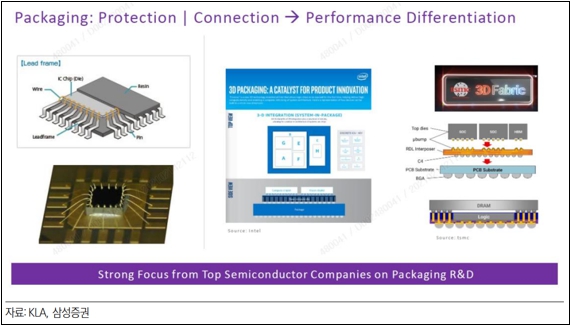
이러한 변화에 대응하기 위해 정부차원에서도 과학기술정보통신부와 산업통상자원부 산하 조직으로 '차세대지능형반도체사업단'을 설립하여 국가 차원에서 후공정을 담당하는 반도체 패키징·테스트 수탁기업(OSAT) 지원책을 연구하고 있으며 2029년까지 총 1조96억원의 예산이 투입될 예정이다.
국내 주요 반도체 기업들도 이러한 변화에 대응하기 위해 조직 및 투자를 확대하 고있는
상황이다. 삼성전자의 경우 6월에 후공정 고도화를 위한 ‘어드밴스드 패키징사업화 테스크포스’를 DS 부문장 직속으로 만들었으며 SK 하이닉스는 파운드리 사업 확대에
나서면서 후공정 시설 투자에도 적극적으로 나서면서 올 7월에 미국에 150억달러를
첨단 패키징 제조시설 및 연구개발에 투자한다는 계획을 밝힌 바 있다. 두산 그룹도 국내 1위 테스터 업체인 테스나를 인수하면서 반도체 패키징 사업에 뛰어들었으며 향후 5년
내 1조원을 투자하여 글로벌 후공정 톱5로 육성한다는 계획이다.
3S는 2007년부터 반도체 웨이퍼용 캐리어 (FOSB, FOUP)를
양산하고 있는 국내 유일의 기업으로서 국내외 웨이퍼 제조사에 FOSB를 공급해오고 있다. FO-PLP 관련하여서는 최초로 2016년도 국내 S사와 개발을 하였었고 2020년 네패스 라웨와 600-300mm를 개발하였고 올해 7월에는 싱가포르의 Chiplet 전문업체인 Silicon Box사로부터 공정용 캐리어
공급계약을 체결하고 현재 개발중인 상황이다.
“FOSB 제품의 경우 후발주자로서 기술개발 및 특허면에서 많은 어려움이 있었지만 사출 형태의 FO-PLP 제품에
대해서는 최고의 개발 기술 및 노하우를 확보한 상태이다. 이를 바탕으로 국내외 업체들에 공격적인 마케팅을
펼칠 계획이며 이미 몇몇 후공정 업체로부터 관련 기술 개발에 대한 문의 및 협의가 진행중인 상황이다.” 라고
3S 관계자는 말하고 있으며 “향후 웨이퍼 제조공정 및 반도체
후공정에 사용할 수 있는 아이템을 추가로 확보하여 FOSB 위주의 매출 구조에서 웨이퍼 제조 – 반도체 후공정 캐리어 전문업체로 거듭나겠다”는 앞으로의 계획을 밝혔다.

